


 2023-12-05
2023-12-05
 579
579
金剛石是一種具有最高導(dǎo)熱率的超寬帶半導(dǎo)體,是一種具有傳遞熱量能力的材料。由于這些特性,金剛石半導(dǎo)體器件可以在比硅等傳統(tǒng)半導(dǎo)體材料更高的電壓和電流下工作(使用更少的材料),并且仍然散熱而不會導(dǎo)致電氣性能下降。
“要擁有一個需要高電流和高電壓的電網(wǎng)來提高太陽能電池板和風(fēng)力渦輪機等應(yīng)用的效率,那么我們需要一種沒有熱限制的技術(shù)。這就是鉆石的用武之地,”Bayram說。
盡管許多人將鉆石與昂貴的珠寶聯(lián)系在一起,但鉆石可以在實驗室中更經(jīng)濟、更可持續(xù)地制造,從而使其成為可行且重要的半導(dǎo)體替代品。天然鉆石是在地球表面深處在巨大的壓力和熱量下形成的,但由于它本質(zhì)上只是碳(含量豐富),因此合成鉆石可以在數(shù)周而不是數(shù)十億年的時間內(nèi)制成,同時它還可以減少 100 的碳排放 次。

在這項工作中,Bayram 和 Han 展示了他們的金剛石裝置可以承受大約 5 kV 的高電壓,盡管電壓受到測量設(shè)置而不是裝置本身的限制。理論上,該器件可承受高達(dá)9kV的電壓。這是金剛石裝置報告的最高電壓。除了最高的擊穿電壓外,該器件還表現(xiàn)出最低的漏電流,可以被認(rèn)為是一個具有能量的漏水水龍頭。漏電流影響器件的整體效率和可靠性。
Han說:“我們制造了一種更適合未來電網(wǎng)和其他電力應(yīng)用中的高功率、高電壓應(yīng)用的電子設(shè)備。” “我們在超寬帶隙材料合成金剛石上構(gòu)建了該設(shè)備,這有望提高效率。” 以及更好的性能。” “性能比當(dāng)前一代的設(shè)備更好。希望我們能夠繼續(xù)優(yōu)化該設(shè)備和其他配置,以便我們能夠接近金剛石材料潛力的性能極限。”
以下為論文原文 :
具有高擊穿電壓的金剛石p型橫向肖特基勢壘二極管(0.01mA/Mm時為 4612V):
金剛石是一種新興的高功率電子半導(dǎo)體,具有大帶隙(EG,5.47 eV)、大臨界電場(EB,10 – 20 MV/cm)、高載流子遷移率(μ,高達(dá) 2100 cm2?V? 1? s?1 對于低摻雜濃度 (<1015 cm?3)) 和高導(dǎo)熱率 (k, 22 - 24 W? cm?1?K?1 ) 的空穴 [1]。p 型硼摻雜劑相對較低的活化能(0.38 eV,而 n 型磷為 0.57 eV)以及 CVD 生長的硼摻雜金剛石的成熟促使 p 型金剛石肖特基二極管用于研究 [2] 和高臨界領(lǐng)域 7.7 MV/cm [3] 和 2.5 kV [4] 的擊穿電壓已在垂直或偽垂直配置中得到證實。在這些器件中提高擊穿電壓需要增加漂移層厚度 [5],這對實驗生長具有挑戰(zhàn)性 [6]、[7],并且蝕刻得更深,這會產(chǎn)生加工問題 [8]。將金剛石 SBD 縮放到更高電壓的一種方法是使用其橫向配置,其中擊穿電壓通過調(diào)整陽極和陰極之間的距離來縮放,而不需要厚的漂移層。

在這篇文中,報道了通過接觸再生和邊緣終止技術(shù)實現(xiàn)的具有高擊穿電壓 (4612 V) 的金剛石 p 型橫向肖特基勢壘二極管 (SBD)。使用熱電子發(fā)射模型和 Mott-Gurney 關(guān)系研究正向 I-V 特性。使用 Synopsys 的 Sentaurus TCAD 軟件在反向偏壓下模擬 SBD,以研究場板結(jié)構(gòu)的影響。仿真預(yù)測,添加場板后峰值電場會顯著降低,這與實驗測量的有或沒有場板的二極管的擊穿性能一致。最后,橫向 SBD 在比導(dǎo)通電阻 (RON) 和擊穿電壓 (Vbr) 方面與之前報道的金剛石功率器件進行了基準(zhǔn)測試。
器件制造:
圖1顯示了金剛石p型橫向SBD的外延(通過微波等離子體增強化學(xué)氣相沉積(MPCVD))和潔凈室微加工工藝流程。首先,在 3×3 mm2 Ib (100) 型高壓高溫 (HPHT) 金剛石基板上生長 2μmp? 漂移層 ([B] <8×1015 cm?3])。使用光學(xué)輪廓測定法測量外延層的RMS表面粗糙度為7.5nm。然后,選擇性生長200 nm p+金剛石([B]~3×1020 cm-3])以形成歐姆接觸區(qū)。通過電子束蒸發(fā) Ti (30 nm)/Pt (30 nm)/Au (100 nm) 形成歐姆金屬接觸,然后在 Ar 氣體環(huán)境中在 450 °C 下熱退火 50 分鐘。歐姆接觸的比接觸電阻通過 TLM 測量確定,測量結(jié)果為 1.25 ±0.98×10?4Ω -cm2。接下來,通過電子束蒸發(fā)沉積 300 nm Al2O3 場板,然后進行剝離工藝。選擇 Al2O3 作為場氧化物是因為它相對于金剛石具有較高的介電常數(shù)(對于沉積的 Al2O3,k=8.63 ± 0.07),這會降低氧端接金剛石的電場強度和較大的能帶偏移 [9], [10]。在肖特基接觸沉積之前,暴露的金剛石表面在室溫下經(jīng)過臭氧處理 1.5 小時以獲得穩(wěn)定的氧終止[11]。Mo (50 nm) / Pt (50 nm) / Au (100 nm) 的肖特基金屬疊層通過電子束蒸發(fā)沉積。Al2O3 場板的內(nèi)半徑和外半徑分別為 40 μm 和 80 μm。肖特基接觸的半徑為60μm,歐姆接觸和肖特基接觸之間的間距為d=80μm。帶有場板的圓形結(jié)構(gòu)金剛石p型橫向SBD的俯視顯微鏡圖像如圖1(f)所示。
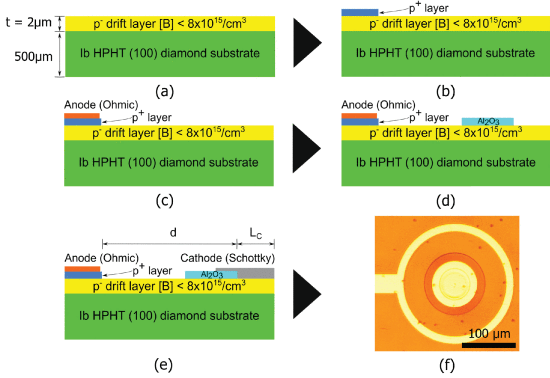
圖1:金剛石橫向 SBD 的外延和潔凈室微加工步驟 (a)p-漂移層外延生長;(b)p+ 接觸層選擇性生長;(c)歐姆接觸沉積;(d)Al2O3場板形成;(e) 肖特基接觸沉積;(f) 使用視場板制造的金剛石橫向 SBD 的俯視顯微鏡圖像。
結(jié)果與討論:
圖 2(a) 顯示了室溫下帶有和不帶有 Al2O3 場板的金剛石 p 型橫向 SBD 的半對數(shù)和線性(插圖)J-V 曲線。沒有場板的SBD具有相同的肖特基到歐姆距離d=80μm,并且肖特基接觸半徑與Al2O3場板的內(nèi)半徑相同。兩個二極管在 +/-5 V 范圍內(nèi)的整流比均為 107。對于帶場板和不帶場板的 SBD,40 V 正向偏置下的線性電流密度分別為 0.049 mA/mm 和 0.044 mA/mm。SBD 在進行高溫和擊穿測量之前經(jīng)過多次重新處理,并在正向 J-V 特性中表現(xiàn)出良好的再現(xiàn)性。對于具有和不具有 FP 的 SBD,四個制造批次之間在 40 V 正向偏壓下的正向電流密度的最大差異分別為 15% 和 6%。零偏壓下的肖特基勢壘高度 (SBH) 使用熱電子發(fā)射模型根據(jù)正向 J-V 曲線的對數(shù)線性區(qū)域進行擬合來估計:

其中 JS 、 A* 、 T 、 n 、 q 、 phiB 和 kB 是反向飽和電流密度、理查森常數(shù)(金剛石 [12] 為 90 A cm?2 K2)、絕對溫度、理想因子、基本電荷、SBH 和 分別為玻爾茲曼常數(shù)。帶和不帶場板的 SBD 提取的理想因子分別為 4.77 和 3.71。根據(jù)四個制造的 SBD 的配件估算的 SBH 為 1.02 ± 0.01 eV。SBH 與先前報道的橫向器件中的其他鉬金剛石肖特基接觸非常一致 [13]。
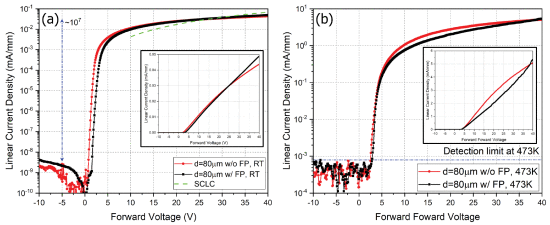
圖 2:(a)室溫 (RT) 下,帶和不帶場板 (FP) 的金剛石橫向 SBD 的正向J -V 特性,以半對數(shù)和(插圖)線性標(biāo)度表示;虛線表示計算出的空間電荷限制傳導(dǎo) (SCLC) J -V 關(guān)系。(b) 200 °C 時,帶和不帶 FP 的金剛石橫向 SBD 的正向J -V 特性,采用半對數(shù)和(插圖)線性標(biāo)度。
圖 2(a) 還繪制了所制造的二極管中 10 – 40V 正向電壓下計算的空間電荷限制傳導(dǎo) (SCLC) 電流密度。由于摻雜劑在室溫下不完全電離,漂移區(qū)的活性空穴濃度估計低于1014 cm?3。隨著施加的正向偏壓增加,注入電荷在漂移區(qū)累積,電荷中性不再保持,SCLC 開始占主導(dǎo)地位 [14]。對于輕摻雜半導(dǎo)體,SCLC 由 Mott-Gurney 關(guān)系描述:

其中 J 、 ?r 、 ?0 、 μ 、 V 和 d 分別是電流密度、相對介電常數(shù)、自由空間介電常數(shù)、載流子遷移率、漂移區(qū)兩端的電壓和漂移區(qū)的長度。計算出的 SCLC 電流與測量數(shù)據(jù)非常一致。在 200 °C 時,大多數(shù)受體被電離,并且?guī)Ш筒粠霭宓?SBD 在 40 V 正向偏壓下的線性電流密度分別顯著增加至 5.39 mA/mm 和 5.09 mA/mm,如圖 2(b) 所示 。
圖3顯示了有和沒有場板的SBD的反向漏電J-V特性。在反向測量過程中,將金剛石晶片浸沒在 3M?Fluorinert?電子液體中,以防止空氣擊穿。當(dāng)泄漏電流急劇增加至 50 μA 的合規(guī)極限時,不帶場板的橫向 SBD 在 1159 V 時擊穿。第一次擊穿后,反向電流密度在低反向偏壓下增加,這證實了泄漏路徑的產(chǎn)生。測量后未發(fā)現(xiàn)肖特基觸點有任何物理損壞。然而,重復(fù)的擊穿測量表明擊穿電壓有所下降。帶有場板的 SBD 表現(xiàn)出高達(dá) 4612 V 的穩(wěn)定漏電流,這是 Fluorinert? 電子液體的極限。4612V反向偏壓下的漏電流密度小于0.01mA/mm,與擊穿前沒有場板的SBD相似。相對較高的穩(wěn)定漏電流可歸因于外延生長的漂移層的高表面粗糙度(RMS粗糙度= 7.5 nm),這是由粗拋光和隨機生長缺陷引起的。

圖 3:帶和不帶 FP 的金剛石橫向 SBD 的室溫反向漏電J -V 特性。
圖 4 顯示了在 3 kV 反向偏置電壓下,在有和沒有場板的情況下,橫向 SBD 沿距金剛石-肖特基接觸界面 0.1 μm 處的虛線切割線模擬的水平電場強度。Synopsys Sentaurus TCAD 軟件用于研究 Al2O3 場板的影響。結(jié)合了經(jīng)驗遷移率模型 [15]、Overstraeten 和 Man [16] 模型的碰撞電離系數(shù)、摻雜劑的不完全電離以及由于鏡像力導(dǎo)致的肖特基勢壘降低。在電場擁擠嚴(yán)重的金屬-半導(dǎo)體界面附近的漂移區(qū)域檢查電場強度。仿真預(yù)測,添加 300 nm 厚的 Al2O3 場板后,肖特基接觸邊緣附近的峰值電場將減少 56%。
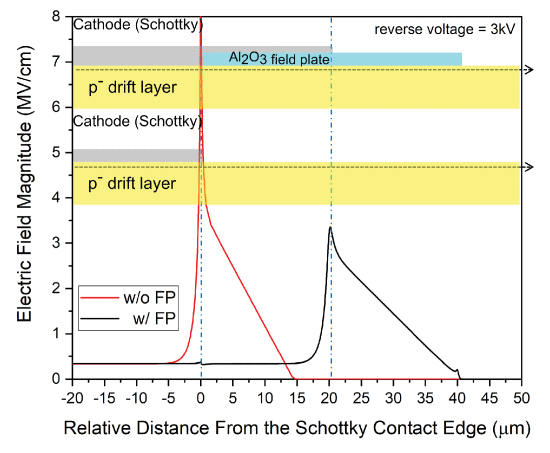
圖 4:沿著虛線切割線的模擬水平電場強度0.1微米_ 遠(yuǎn)離金剛石-肖特基接觸界面,用于在 3 kV 反向偏壓下帶或不帶 FP 的橫向 SBD。
圖 5 顯示了特定導(dǎo)通電阻 (RON) 與擊穿電壓 (Vbr) 的基準(zhǔn)在室溫下。這項工作表現(xiàn)出比先前報道的偽垂直和垂直 SBD、橫向 MESFET、MOSFET 和 JEFT 更高的擊穿電壓。
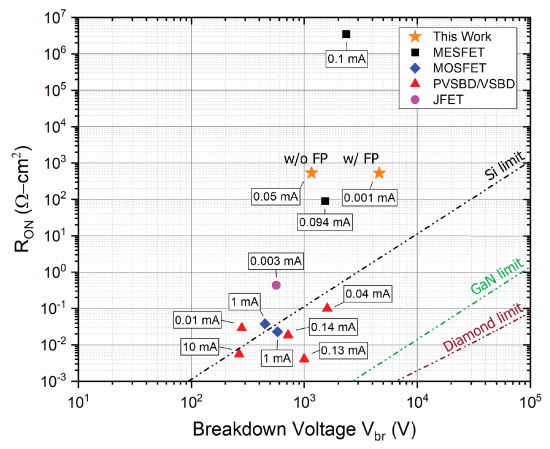
圖 5:所制造的橫向 SBD 與之前報道的金剛石功率器件(包括橫向 MESFET、MOSFET 和Jet FET,以及室溫下的偽垂直和垂直 SBD)進行比較的基準(zhǔn)。括號中顯示了報告擊穿時的漏電流。
對于帶場板和不帶場板的 SBD,比導(dǎo)通電阻分別歸一化為 527 Ω -cm2 和 534 Ω -cm2。RON 值比最先進的偽垂直和垂直 SBD 高 3 到 4 個數(shù)量級。考慮到歐姆接觸的低比接觸電阻 (1.25 ±0.98×10?4Ω -cm2),較大的 RON 可歸因于空間電荷限制傳導(dǎo) (SCLC) 以及與 p? 漂移層相關(guān)的空間電荷區(qū)域。n型Ib型金剛石基板,可減少電流傳導(dǎo)的活性層厚度。可以通過研究漂移層厚度和摻雜來優(yōu)化 RON。較厚的溝道可以增加線性電流密度[20],從而降低 RON。還可以增加漂移層摻雜濃度以克服 SCLC 并允許更短的漂移層。
結(jié)論:總而言之,報告了帶有和不帶有 Al2O3 場板的金剛石 p 型橫向 SBD。在室溫下,二極管的整流比為 107,在 40 V 正向偏壓下,正向電流密度為 0.049(帶場板)和 0.044(無場板)mA/mm。具體導(dǎo)通電阻為 534(無場板)和 527(有場板)Ω -cm2。在反向偏壓下,兩個二極管在擊穿前的漏電流密度均低于 0.01 mA/mm。Al2O3 場板將擊穿電壓從 1159 V 提高到 4612 V,并且對 I-V 行為沒有明顯影響。使用 Synopsys 的 Sentaurus 軟件通過 TCAD 模擬研究了 Al2O3 場板的影響,該軟件預(yù)測在 3 kV 反向偏壓下使用 Al2O3 場板時峰值電場強度會降低 56%。最后,提出了橫向 SBD 在比導(dǎo)通電阻與擊穿電壓方面的基準(zhǔn)。擊穿電壓是迄今為止 p 型金剛石肖特基二極管中最高的擊穿電壓之一。然而,需要進一步優(yōu)化漂移層厚度和摻雜濃度,以降低 RON 并更接近金剛石的材料極限。
文章僅作行業(yè)分享,部分圖片來自互聯(lián)網(wǎng),無法核實真實出處,如涉及侵權(quán),請直接聯(lián)系刪除。